マスクレス露光装置
ナノリソグラフィー装置群
| 装置番号/ARIM設備ID | A21/KT-121 |
|---|---|
| 装置名 | マスクレス露光装置 Advanced Maskless Aligner |
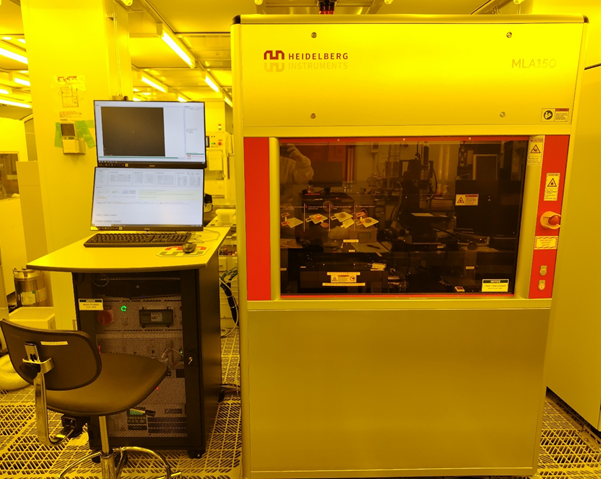
|
|
| 製造社名 | Heidelberg Instruments (https://heidelberg-instruments.com/) |
| 品名・型番 | THE ADVANCED MASKLESS ALIGNER MLA150 |
| 特徴 | ・波長375nm、DMD方式のマスクレス露光装置 |
| キーワード | |
| 設置場所 | 総合研究6号館 イエロールーム(施設情報) |
| 装置利用料金 | こちらをご覧ください |
仕様
| 光源 | レーザーダイオード |
| 主波長 | 375 nm |
| 最小描画線幅 | 1.0 μm |
| 最小描画L/S | 1.2 μm |
| ワークサイズ | Φ5 mm ~ ▢6 inch |
| ワークサイズ(厚み) | 0.1 mmt ~10 mmt |
参考画像
1枚目:高速描画
約10mm(4インチ)角にほぼ全面に4μmのドットの描画が20分で終了する
2枚目:SU-8 描画事例
SU-8を直接露光可能
(実例)PDMS用流路のモールド
3枚目:1um程度の描画
左 1umの単独ラインの描画結果
カタログスペックが1μm
右 2μmライン&スペースの描画結果
カタログスペックは1.2μmL&S